
主營產品:
光學儀器、光學材料、實驗儀器、手動工具、焊接工具、焊接材料、儀器儀表、靜電設備、靜電輔料、工業器材、氣動元件、電工電氣、測量工具、計量設備、氣動工具、電動工具、化工設備、化工輔料、點膠設備、小型設備、儲存設備、物流設備、工業安防、**防護、包裝材料、切削工具、切削材料、辦公設備、辦公文 具、工裝夾具、測試治具、機械加工。設備等。
- 西南區廠家直銷 FUNATEC...
- 廠家直銷 MUSASHI武藏 ...
- AITEC艾泰克 Power-...
- 重慶上乘粘度計 TOKISA...
- 西南區廠家直銷EIWA熔接機拉...
- 功能齊全 重慶內藤銷售 KOB...
- 原裝進口 靜電測量儀 FMX-...
- 折疊耐久試驗機 DLDMLH...
- SEN日森 UV硬化裝置 臺式...
- HID光源 HL - LGJ ...
- USHIO牛尾 照明設備 一般...
- 新品直銷,OPK株式會社,托盤...
- 現貨直銷 SANEI三榮 BS...
- 現貨直銷 SANEI三榮 SD...
- 西南地區直銷 MOUNTZ蒙士...
- DLDMLH-4U 折疊耐久...
- 折疊耐久試驗機 DLDMLH-...
- 現貨 DIT東日技研 超聲波傳...
- 現貨 DIT東日技研 靜電消除...
- 現貨 DIT東日技研 噴嘴式/...
- 重慶內藤供應AITEC艾泰克L...
- AITEC艾泰克 氮置換BOX...
- AITEC艾泰克 晶圓UV照射...
- AITEC艾泰克 閃光燈設定數...
- AITEC艾泰克 LPDCH系...
- AITEC艾泰克 LMS 10...
- AITEC艾泰克 紅外線照明 ...
- NDK日本電色 濁度/色度儀...
- 日本MUSASHI武藏高精度點...
- 現貨充足拉拔機TND-4500...
- 日本FLUORO福樂 小型真...
- 西南地區總代理 MUSASHI...
- 日本FLUORO福樂真空吸筆重...
- 日本AITEC艾泰克視覺檢測燈...
- 西南代理 日本MUSASHI武...
- 日本SIMCO思美高除靜電離子...
- 西南代理 YIZIMO鈑金修復...
- 日本AITEC艾泰克UV-LE...
- 日本TECHNO特古羅無鉛用焊...
- 日本MUSASHI武藏數碼控制...
- 西南地區總代理MUSASHI武...
- 重慶代理 YIZIMO鈑金修復...
- 日本AITEC艾泰克UV-LE...
- 日本FLUORO福樂小型真空泵...
- 總代理現貨TND-4500K ...
- 日本MUSASHI武藏數碼控制...
- 日本IMV艾目微地震監測設備 ...
- 日本SIMCO思美高除靜電離子...
產品詳情
簡單介紹:
對應于從薄膜到厚膜的寬膜厚度
功能齊全 重慶內藤銷售 FE-300V 薄膜厚度監視器 OTSUKA大塚電子
使用反射光譜的厚度分析
功能齊全 重慶內藤銷售 FE-300V 薄膜厚度監視器 OTSUKA大塚電子
結構緊湊·成本低,但非接觸式,非破壞性和高度**的測量
簡單的條件設置和測量操作!易于測量任何人的膜厚度
詳情介紹:
它是一種緊湊,低成本的薄膜厚度計,可以通過高精度的光學干涉方法實現薄膜厚度測量,操作簡單。
我們采用了一體化的房屋,在主體中容納了必要的設備,實現了穩定的數據采集。
光學常數的分析也可以通過獲得**反射率來實現,盡管它是低成本的。
我們采用了一體化的房屋,在主體中容納了必要的設備,實現了穩定的數據采集。
光學常數的分析也可以通過獲得**反射率來實現,盡管它是低成本的。
(詳情請咨詢TEL:18375760285 QQ;1280713150 白先生)
特點
- 對應于從薄膜到厚膜的寬膜厚度
- 使用反射光譜的厚度分析
- 結構緊湊·成本低,但非接觸式,非破壞性和高度**的測量
- 簡單的條件設置和測量操作!易于測量任何人的膜厚度
- 通過非線性*小二乘法,優化方法,PV方法,FFT分析方法等可以進行各種各樣的膜厚度測量。
- 通過非線性*小二乘法的膜厚度分析算法可以進行光學常數分析(n:折射率,k:消光數計數)
測量項目
- **反射率測量
- 薄膜厚度分析分析(10層)
- 光學常數分析(n:折射率,k:消光米數)
應用程序使用
-
功能性膜,塑料
的透明導電膜(ITO,銀納米線),相位差膜,偏振膜,AR膜,PET,PEN,TAC,PP ,PC,PE,PVA, 膠,粘合劑,保護膜,硬外套,指紋等 -
半導體
化合物半導體,Si,氧化膜,氮化膜,Resist,SiC,GaAs,GaN,InP,InGaAs,SOI,藍寶石等 -
表面處理的
DLC涂層,防銹劑,防霧劑等 -
光學材料
過濾器,AR涂層等 -
FPD
LCD(CF,ITO,LC,PI),OLED(有機薄膜,密封劑)等 -
其他
硬盤,磁帶,建筑材料等
測量原理
使用大冢電子,光學干涉測量和我們自己的高精度分光光度計可實現非接觸,無損,高速和高精度的薄膜厚度測量。光學干涉測量法是通過使用由使用如圖1所示的分光光度計的光學系統獲得的反射率來獲得光學膜厚度的方法。例如,如圖1所示,在金屬基板上涂布膜的情況下,從目標試樣的上方入射的光被膜(R1)的表面反射。而且,透過膜的光在基板(金屬)或膜界面(R2)上反射。測量此時由于光程差引起的相移引起的光學干涉現象,并根據所獲得的反射光譜和折射率計算膜厚度的方法稱為光學干涉方法。有四種分析方法:峰谷方法,頻率分析方法,非線性*小二乘法和優化方法。
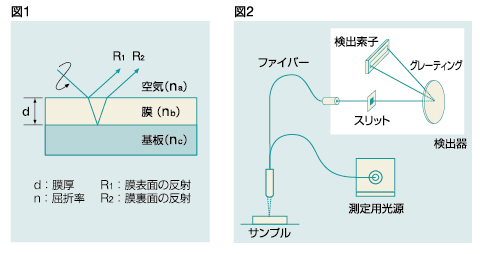
產品規格
| 模型 | FE-300V | FE-300 UV | FE-300 NIR * 1 | |
| 整個 | 標準測量類型 | 薄膜測量類型 | 厚膜測量類型 |
厚膜測量類型 (高分辨率) |
| 樣本大小 | *大8英寸晶圓(厚度5毫米) | |||
|
測量的薄膜厚度范圍 (nd) |
100納米到40微米 | 10納米至20微米 | 3μm至300μm | 15微米到1.5毫米 |
| 測量波長范圍 | 450納米到780納米 | 300nm至800nm | 900nm至1600nm | 1470nm至1600nm |
| 薄膜厚度精度 | ±0.2 nm * 2以內 | ±0.2 nm * 2以內 | - | - |
| 重復性 | 在0.1納米* 3以內 | 在0.1納米* 3以內 | - | - |
| 測量時間 | 在0.1秒到10秒內 | |||
| 點直徑 | φ約3毫米 | |||
| 光源 | 鹵素 | 氘和鹵素混合 | 鹵素 | 鹵素 |
| 接口 | USB | |||
| 尺寸,重量 | <280(W)×570(D)×350(H)mm,約24kg | |||
| 軟件 | ||||
| 標準 | 峰谷分析,FFT分析,優化方法分析,*小二乘分析 | |||
| 選項 | 材料評估軟件,后期分析軟件,膜模型分析,參考板 | |||
* 1請與我們聯系以獲取詳細信息
* 2
超大規模集成電路薄膜厚度保證(100納米二氧化硅/硅)* 3 所述的測量保證值范圍對于VLSI薄膜厚度標準(100納米二氧化硅/硅)重復測量的不確定性(包含因子2.1)
光學系統圖

軟件屏幕

相關產品











